上期我们介绍了在布线操作中的布线优化操作,实现PCB的合理规范走线;本期我们将讲解在Allegro PCB设计中的扇出孔操作。?
2.BGA的焊盘间距小的时候,直接在表层走线通常比较困难,通过扇出操作能够将信号分配到其他布线层。?
3.扇出孔操作能够为差分对、等长线、电源分割等信号完整性处理提供更多的空间;扇出孔就是咱们PCB设计师在应对高密度芯片时,化平面为立体、化拥挤为通畅的核心战术手段。?
2、Cadence软件配置:Allegro X Designer Plus 24.1-2024 P001 [9/4/2024] Windows SPB 64-bit EditionEdition

2.点击Find界面,仅勾选“Symbols”,选择一个BGA符号右键done,这样该BGA就成功扇出孔。

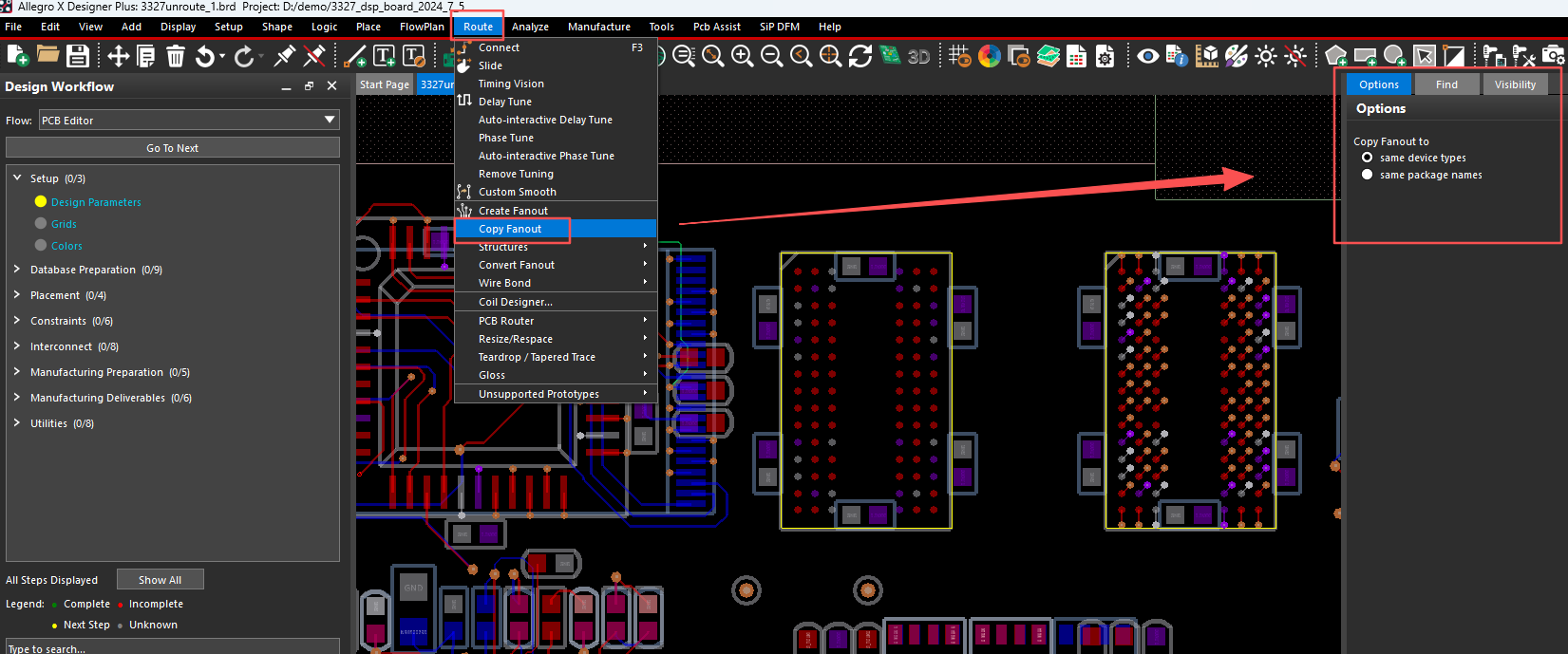
3.在Find界面仅勾选Symbols,接着点击封装器件,可以看到旁边的相同的封装形式的封装扇出形式一比一复制扇出方式。
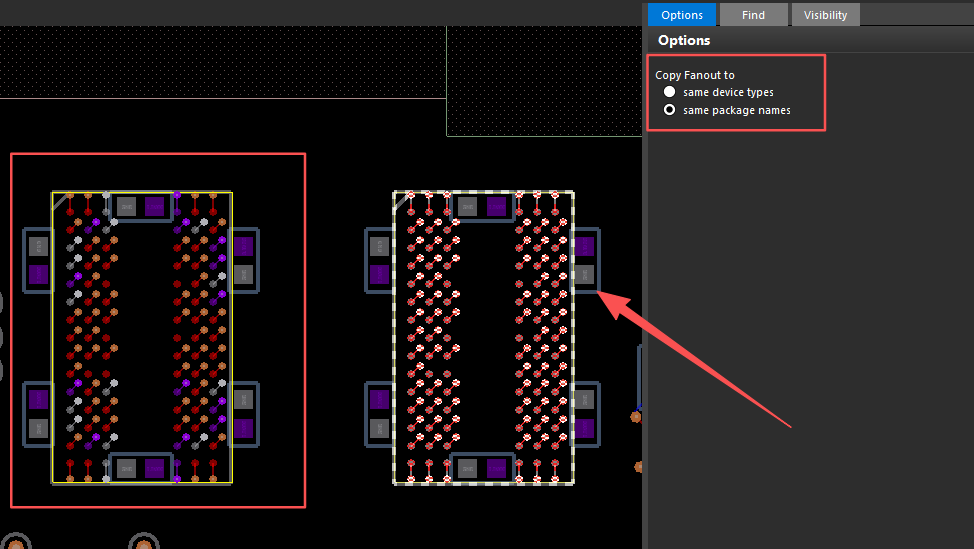
2.在设计窗口的Find界面,勾选Vias或Clines。
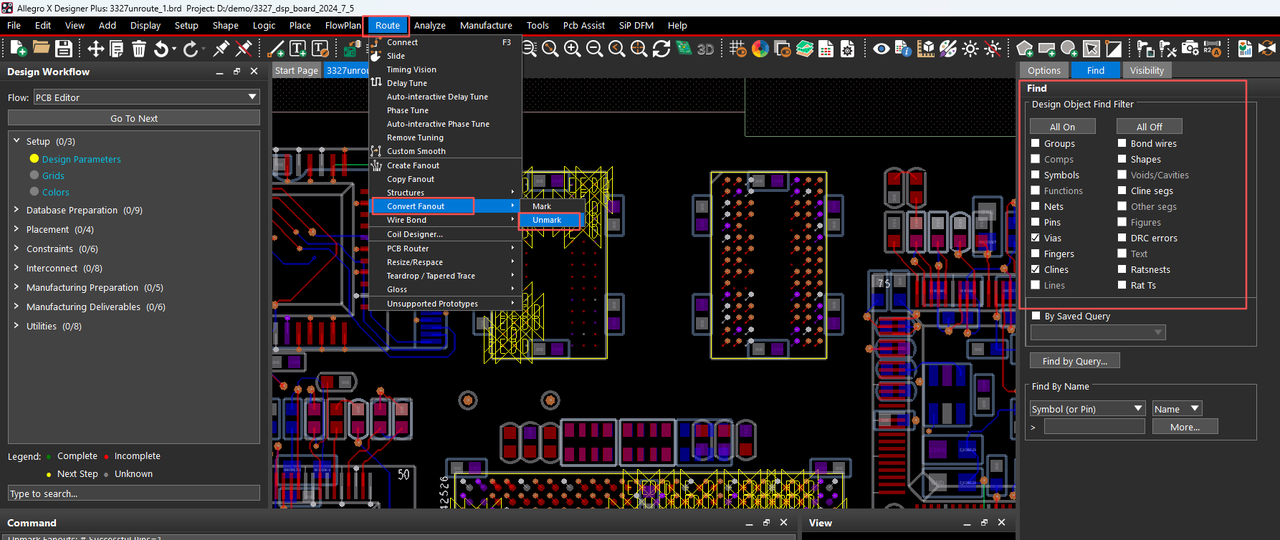
3.在设计窗口中选择与元器件的扇出的孔或线段,选择完成后点击鼠标右键done。此时的所选的孔和线段与元件就无关联性,移动该元件位置,选择的孔和线槽则不会再随之移动。

在BGA扇出的时候,通常情况是以BGA的正中心延申一个十字通道。这样的扇出方式有利于增大走线通道、增大电源平面通道,同时增加芯片的本身的散热。
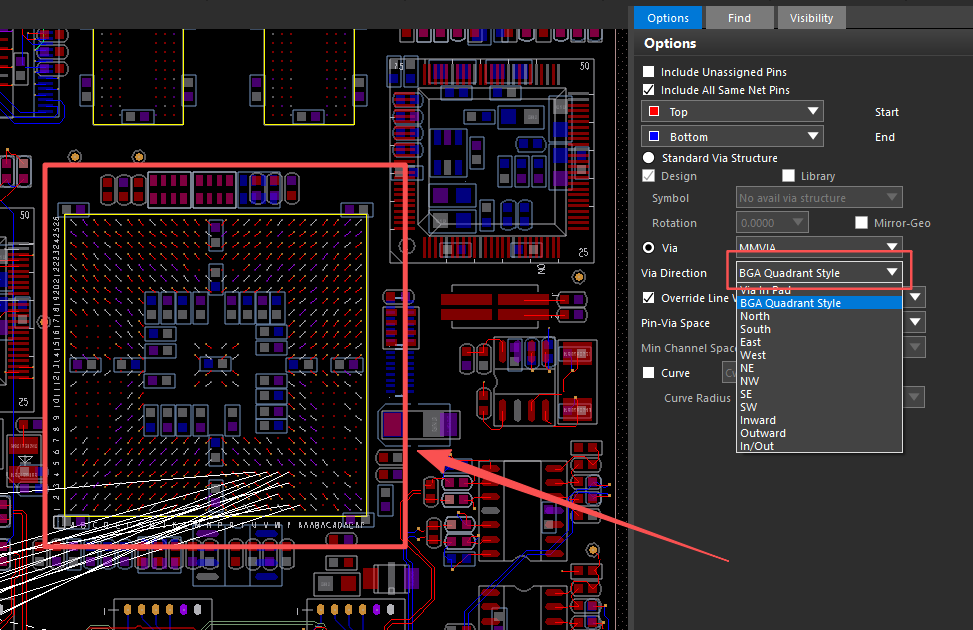
2、BGA封装采用Via in pad扇出方式
对于引脚间距小于等于0.8mm的BGA封装,可选用盘中孔的扇出方式;采用此种扇出方式会给整个板子上的布线预留更多的空间。

3、对于QFN/LCC封装
对于中间的散热焊盘,使用多个过孔阵列直接扇出到内地平面,提高散热和接地质量。对于四周的信号引脚,采用常用的向外扇出方式。
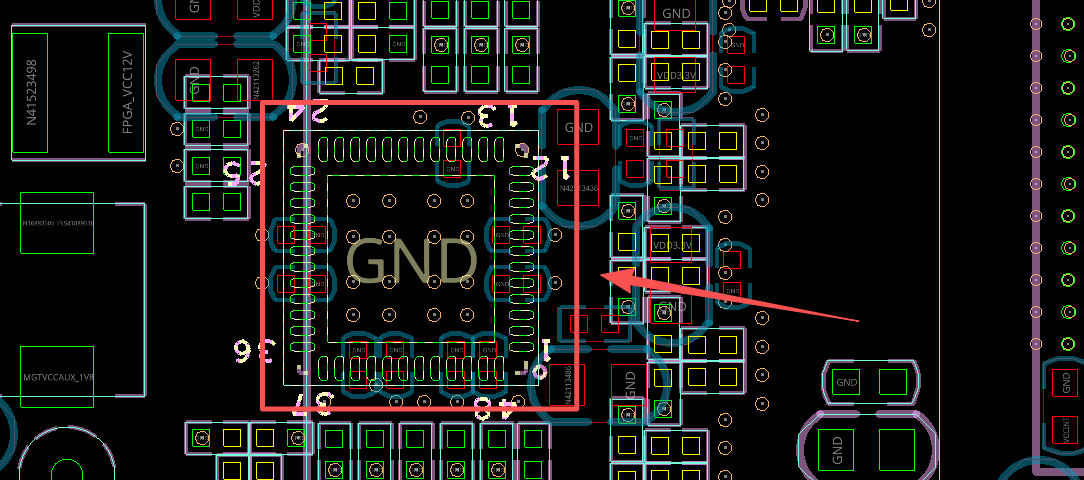
4、高速信号(DDR、PCLe、SERDES)
这类封装器件的扇出通常采用对称扇出,对于差分对信号,其扇出的两个孔应尽可能靠近,保持平行,长度一致,以确保差分阻抗连续并避免模式转换;在关键的高速信号过孔旁添加接地过孔。

5、常规的IC封装采用inward/outward方式扇出
此类封装打孔需要注意不能把孔打得太密集造成信号回流地平面和电源平面不完整,故在打孔时需要错开打孔,保证每两个VIA之间可以通过1~2根走线。
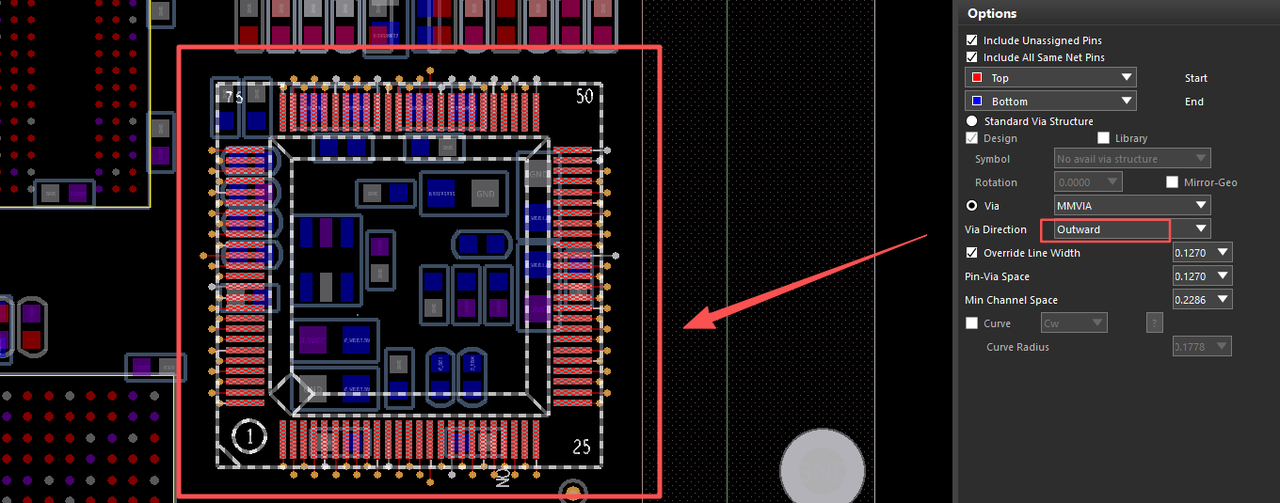
本期主要介绍了Allegro X Designer Plus中的扇出操作以及常用的元器件的扇出选择,下一期我们将为大家讲解PCB的元器件布局操作,使得整个PCB设计更合理、美观。?
Allegro X Design Platform
Cadence Allegro X Design Platform 是一个强大且统一的系统设计解决方案,为协作式的团队工作环境提供支持,满足前沿、现代的电子设计需求。无论是错综复杂、技术要求严格的系统,还是普通的电路要求,该平台都可以轻松应对。它提供了一个集成的生态系统,包括原理图设计、PCB layout 和设计同步分析(In-Design Analysis,IDA),由集中管理的可视化设计数据提供支持,有效避免了不必要的设计冲突和错误。


